晶方科技:股票投资分析报告
温馨提示:这篇文章已超过1146天没有更新,请注意相关的内容是否还可用!
①业务概述
晶方科技成立于2005年6月,成立之初成功引进吸收以色列晶圆级封装技术(Shellcase 的ShellOP和ShellOC,获得技术许可)后,其对引进技术不断消化吸收,逐渐将其应用拓展至MEMS和LED领域,成为大陆首家、全球第二大,能为影像传感芯片提供晶圆级芯片尺寸封装(WLCSP)量产服务的专业高端封测服务商,同时具备8英寸、12英寸晶圆级芯片尺寸封装技术量产能力,目前在全球量产生物身份识别芯片晶圆级封装技术领域处于引领地位。
(报告全文约为10000字。本文为报告的第一部分,即公司产品和业务的详细梳理。剩余部分会继续对公司当前及未来竞争力进行深度解读,可在公号“估股”中阅读。)
初创期:2005年6月,在自然人王蔚(是公司当前董事长和总经理)的撮合下,Shellcase、中新创投、英菲中新在苏州工业园区共同投资设立了晶方科技,由王蔚担任总经理负责公司组建、日常经营管理等相关事宜。根据双方约定:晶方科技从使用该项技术实现收入之日起至商业性销量触及2000片晶圆后三年内,按与这两项技术直接相关的服务收入总额的5%计缴权利金;协议期限的其他时间,按与上述两项技术直接相关的服务收入总额的3%计缴权利金。虽然后续晶方科技对其授权技术进行不断吸收并创新,但由于创新技术是基于授权技术,因此仍然需要交纳一定的授权金。
发展期:2010年~2013年公司进入快速发展阶段,开拓了大客户比亚迪、格科微、思比科等;2013年~2014年又开始为苹果IPhone5s/6指纹识别芯片提供先进封装业务,公司2014年收购DRAM专业封测厂智瑞达电子,拥有LGA、BGA、SIP模组等多样化的封装技术和模组制造能力,同时结合其先进的封装技术,率先推出了国际领先的传感器扇出型系统级(Fan-out SiP)封装技术,将其封装技术应用于汽车影像领域。
动荡期:2015年公司退出苹果产业链,业绩下滑明显,利润更是下滑近4成。直至2017年依托指纹识别TSV封装业务,公司业绩得以小幅度爆发,也是同年国家大基金入股,持股9.32%,为其信用背书。但好景不长,2018年苹果新一代机器弃用指纹识别方案,以及智能手机出货量整体下滑,公司产能利用率不足导致业绩承压。
重新启动:2019年,通过发起设立晶方产业投资基金,参与并购荷兰Anteryon公司,有效拓展公司光学设计、混合镜头、微型镜头制造等核心光学器件设计与技术制造能力。同时国内封测行业受5G、手机声光学等需求拉动,整体呈现回温态势,公司产能利用率改善明显。此外,受益于手机多摄化趋势,其中副摄主要采用WLCSP技术,促使公司该业务再次回暖,加上安防监控持续增长、汽车电子摄像应用兴起,公司封装出货量大幅度增加。2020年公司募集资金大幅扩产,进一步巩固其领先地位。2021年8月9日,晶方产业基金拟出资 1000 万美元投资 VisIC 公司(近期拟追加投资)。交易完成后,晶方产业基金将持有 VisIC 公司 7.94%的股权。此次交易后,公司将触角伸至第三代半导体器件(GaN(氮化镓))设计领域。
2010 年-2020 年先进封装业务一直为公司核心业务,营收占比均在 93%以上,封装业务长期以来对公司的毛利贡献超 90%。设计业务主要是为客户设计能满足其要求的封装技术,每次设计收取一定数额设计费用。主营业务十分突出。
从未来发展战略上来看,公司一方面是拓展先进封装的应用领域(如汽车、安防),另一方面以 CSP 封装为基础,不断向光学器件制造、模块集成、测试业务的延伸,增强与客户的合作粘度。 这种发展战略更多是营销或销售策略,而不是如何打造核心竞争力。
②产品描述
集成电路封测本质属于生产性服务业,主要采购一些封测材料,上游对其不形成制约。由于晶方科技以WLCSP封测方式为主(85%的产品为晶圆级封测产品),因此我们核心介绍WLCSP的工艺流程。
晶圆片级芯片规模封装(Wafer Level Chip Scale Packaging,简称WLCSP),即晶圆级芯片封装方式,不同于传统的芯片封装方式(先切割再封测,而封装后至少增加原芯片20%的体积),此种最新技术是倒装芯片互连技术的一个变种,是先在整片晶圆上进行薄膜沉积,黄光和电化学沉积等制程封装和测试,再切割成尺寸与裸片完全一致的芯片成品,不需经过打线和填胶程序,封装后的芯片尺寸和裸芯片几乎一致(在结束芯片制造前先完成封装)。达到了小型化的极限(封装效率接近100%),符合消费类电子产品轻、小、短、薄化的市场趋势。
除在技术上具备优势,成本上优势也十分明显。WLCSP 封装成本是按照晶圆数计量的,与切割后的芯片数无必然联系,而传统封装的封装成本是按封装芯片的个数计量的,因此随晶圆尺寸的增大和芯片数量增加而降低(目前行业内普遍由8英寸向12英寸升级,利于进一步降低成本)。
相比于传统封装技术难度较高,同时还需承担良率不达预期的风险,因此盈利水平也更高。相比于封测工艺的资金+劳动力密集型,先进封测偏资金+技术密集。
2020 年晶方科技前五大客户营收占比达 88%,相较其他封测厂商处于较高水平,这与其专注于 CMOS 领域有关。根据 Yole,CIS (是CMOS Image Sensor影像传感器的简称)前五大下游客户集中度达 84%。但公司头部客户份额分布较为均衡,2017-19 年公司前五大客户中未有单一客户占比超过 25%的情况。在安防领域,客户主要包括:豪威科技、晶相光电、思特威、SONY 等;手机领域,客户主要包括:豪威、格科微等;汽车领域,客户主要为豪威;指纹识别领域,客户主要是汇顶。客户均为下游头部公司。
③产业链
半导体是电子终端产品的关键组成部分,产业链可分为设计、制造、封测三大环节。半导体设计人员根据需求完成电路设计和布线,晶圆厂在晶圆上完成这些电路的制造,刻好电路图的晶圆再送到封测厂进行封装和测试,检测合格的产品便可应用于终端产品中。
目前半导体企业的经营模式可分为垂直整合和垂直分工两大类。采用垂直整合模式(Integrated Device Manufacturer,IDM)的企业可以独立完成芯片设计、晶圆制造、封装和测试等生产环节。垂直分工模式为Fabless设计+Foundry制造+OSAT封测。Fabless 芯片设计公司采用无晶圆厂模式,只负责研发设计和销售,将晶圆制造、封装、测试外包出去,OSAT(Outsourced Semiconductor Assembly and Testing)为外包封测企业,仅负责封装测试环节,代表企业如华天科技、长电科技、日月光等。
在传统封测市场中,分工化趋势要明显于垂直一体化。但由于先进封装工艺上的特殊性,情况则刚好相反。根据 Frost&Sullivan 数据,在市场竞争格局高度集中的全球 CIS 行业厂商中,IDM 厂商占据约 70%市场份额,排名靠前厂商中仅有豪威和格科微等采取 Fabless 的经营模式(均是公司核心客户)。
在Fabless模式下,芯片设计直接决定芯片的终端应用,在整个产业链中处于主导位置,对于封测厂来讲,虽然芯片设计厂商位于其产业链上游,但往往是独立封装厂商的客户。因此虽然从产业链位置来看,封装厂位于产业链偏下游的位置,但作为生产性服务业,其本质服务于产业链中上游企业,因此本行业的关键能力可能在于研发或管理。
晶方科技的后续分析发布于公号“估股”中,感谢阅读。完整报告目录如下:
九七分享吧所有文章来源于网络收集整理,如有侵权请联系QQ2387153712删除,如果这篇文章对你有帮助或者还不错的请给小编点个小赞(◠‿◠),小编每天整理文章不容易(ಥ_ಥ)!!!





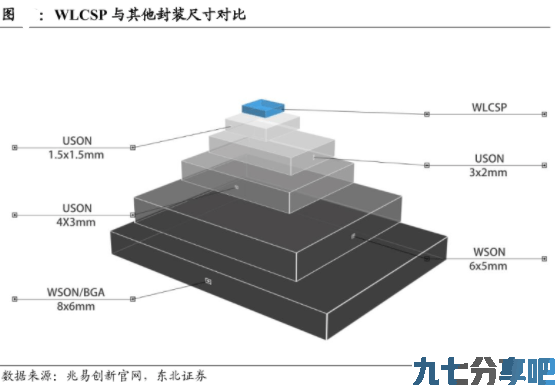
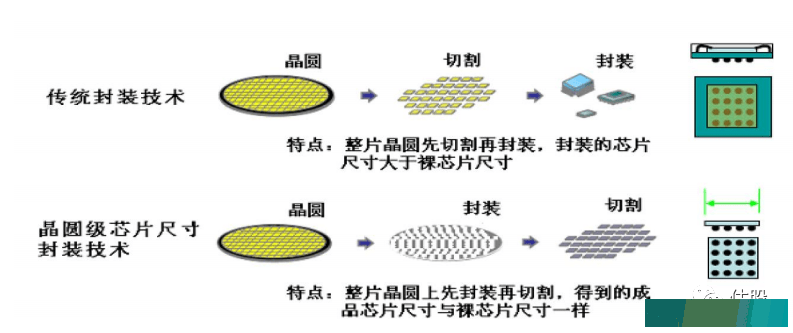








还没有评论,来说两句吧...